フォトレジスト
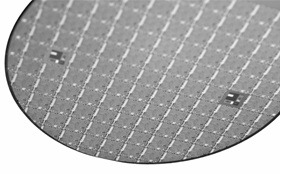
フォトレジストの測定の成功には、いくつもの特有の挑戦を乗り越えることが必要とされ、それは全てフィルメトリクスの自動膜厚測定システムで行うことができます。特有の挑戦には、測定するレジストを光源に晒すことなく、フォトレジストの広域を覆う屈折率ライブラリーにアクセスし、焼付けや露光の度合いで屈折率を変更するためフォトレジストの傾向に対応する能力が含まれます。
| 膜厚測定範囲* | アプリケーション | 製品ライン |
|---|---|---|
| 1nm - 450µm | シングルスポット | F20 |
| 0.4µm - 3mm | シングルスポット | F3-sX |
| 5nm - 3mm | 膜厚マッピング | F50/F60 |
SU-8やその他の厚いフォトレジストの測定は、素早く簡単ではあるもののスピンコーティングが希望の膜厚に従うための不正確な方法となり得るため特に重要です。露光時間はレジスト厚によるため、正確な測定が行われなければなりません。更に、複雑な複数層のマイクロマシン技術構築を形成するため正負のフォトレジストが同時に使用されることもあるため、各層の膜厚を理解する事は非常に重要な課題となります。
フィルメトリクスは、単一膜、多層膜、そして独立フォトレジスト膜でさえも3nmから1mmまで計測可能な、幅広い卓上そしてマッピングシステムを取り揃えています。全てのフィルメトリクスの製品は正確な分光反射率モデリングにより膜厚(と屈折率)を計測します。独自の特別なアルゴリズムにより通常一秒以内に正確な”ワンクリック”分析を行います。
お問い合わせ
アプリケーションを検索する
-
アモルファスとポリシリコン
膜厚測定、結晶化度、全てのアモルファスとポリシリコンの屈折率と消衰係数
APPLICATIONS_amorphous-poly-silicon_FilterKeywords
-
CMP
F80膜厚測定システムは、酸化物、STI、金属CMPプロセスの測定に使用されています。
APPLICATIONS_cmp_FilterKeywords
-
誘電体
フィルメトリクスは産業界で使用される数千もの誘導体膜の測定システムを取り揃えています。
APPLICATIONS_dielectrics_FilterKeywords
-
ハードコート厚
フィルメトリクスのシステムはハードコートやプライマー厚を測定する自動車業界で幅広く使用されています。
APPLICATIONS_hardcoat-thickness_FilterKeywords
-
IC故障解析
F3-s1550はシリコンの裏面シニング測定をするチップ産業で使用されています。
APPLICATIONS_failure-analysis_FilterKeywords
-
ITOとその他のTCO
当社独自の解析アルゴリズムにより、TCO厚、屈折率、消衰係数の測定が測定ボタン一つで可能です。
APPLICATIONS_ito_FilterKeywords
-
医療デバイス
血管形成バルーン、ステント、インプラントコーティング、その他多数の膜厚を測定します。
APPLICATIONS_biomedical_FilterKeywords
-
金属膜厚測定
金属膜の膜厚、屈折率、消衰係数を50nmまで測定します。
APPLICATIONS_metal_FilterKeywords
-
OLED
NPB、lQ3、PEDOT、P3HT、soluble Teflons等の膜厚と屈折率を測定します。
APPLICATIONS_oled_FilterKeywords
-
眼鏡コーティング
F10-ARで屈折率、色、反射防止、ハードコート層厚の測定が可能です。
APPLICATIONS_ophthalmic_FilterKeywords
-
Paryleneコーティング
ParyleneコーティングサンプルをF3-CSのステージ上に置くだけで膜厚の測定が可能です。
APPLICATIONS_parylene_FilterKeywords
-
フォトレジスト
当社は数十もの異なるレジストを測定しており、屈折率ファイルもお使いのレジストに応じて作成できます。
APPLICATIONS_photoresist_FilterKeywords
-
多孔質シリコン
多孔質シリコン膜の膜厚、多孔率、屈折率、消衰係数を測定します。
APPLICATIONS_porous-silicon_FilterKeywords
-
プロセス膜
フィルメトリクスは半導体プロセス膜の測定用に完全なシステムを取り揃えています。
APPLICATIONS_process-films_FilterKeywords
-
屈折率と消衰係数
190-1700nm範囲の屈折率と消衰係数を測定
APPLICATIONS_refractive-index_FilterKeywords
-
シリコンウエハーと膜
フィルメトリクスはシリコンを2mm厚まで測定する為の卓上、マッピング、製造システムを取り揃えています。
APPLICATIONS_si-wafers_FilterKeywords
-
ソーラーアプリケーション
CdTe、CdS、CIGS、アモルファスシリコン、TCO、反射防止層、その他の膜厚を測定します。
APPLICATIONS_solar_FilterKeywords
-
半導体教育研究機関
50台以上のF20が大学機関研究所で使用されています。
APPLICATIONS_teaching-labs_FilterKeywords
-
ウェブコーティング
フィルメトリクスのシステムはインラインのポリマー膜厚測定用に幅広く使用されています。
APPLICATIONS_web-coatings_FilterKeywords